独立行政法人 産業技術総合研究所【理事長 野間口 有】(以下「産総研」という)ナノエレクトロニクス研究部門【研究部門長 金丸 正剛】新材料・機能インテグレーショングループ 前田 辰郎 主任研究員、板谷 太郎 主任研究員らは、住友化学株式会社【代表取締役社長 十倉 雅和】 (以下、「住友化学」という)と共同で、ポリマーを利用した化合物半導体の転写とポリマー上の高性能トランジスタ作製技術を開発した。
今回、産総研の基板貼り合わせ技術とデバイス作製技術、住友化学の化合物結晶成長技術というそれぞれの強みを生かし、ポストシリコン材料デバイスとシリコン大規模集積回路(Si-LSI)の集積化に向けて、(1) 耐熱性能に優れた接着性ポリイミドの開発、(2) 接着性ポリイミドを利用したシリコン基板上への高品質ヒ化インジウムガリウム(InGaAs)層の転写技術の開発、(3) 400℃以下の温度でシリコンの性能を凌駕するトランジスタを作製する技術の開発にそれぞれ成功した。
今回開発した技術によりポストシリコン材料とSi-LSIを融合した高性能・多機能デバイスの開発やエレクトロンデバイスとフォトニックデバイスのより高密度な3次元積層集積化が可能となり、コンピュータの省電力化、高速化、ダウンサイジングが期待できる。
この技術の詳細は、2012年9月25日~27日に京都市で開催される2012年国際固体素子・材料コンファレンス(SSDM 2012) で発表される。
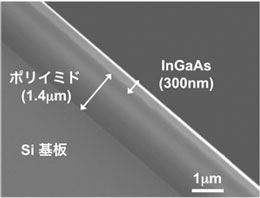 |
|
ポリイミド上のInGaAs層の断面電子顕微鏡像 |
シリコンよりも優れた移動度特性をもつ化合物半導体やゲルマニウムは、ポストシリコン材料と呼ばれ、次世代のチャネル材料として世界各国で研究がすすんでいる。こうしたポストシリコン材料は、これまでのSi-LSIの機能をすべて置き換えるものではないため、必要な性能をもったポストシリコンデバイスが、Si-LSI上の必要なところに搭載され、機能を発揮する必要がある。そのため、Si-LSIを作製した基板上に高品質なポストシリコン材料を転写後、デバイス作製と配線を行うバックエンド集積化という新しい技術が求められてきた。また、ポストシリコン材料はシリコンにはない光学的に優れた物性をもつものが多く、バックエンド集積化技術はSi-LSIとフォトニックデバイスを有機的に融合させるプラットフォーム技術として期待されている。
産総研と住友化学は、2008年よりエレクトロンデバイスとフォトニックデバイスの融合を目指したハイブリッド半導体技術開発の共同研究をすすめており、シリコン基板上で高性能半導体とフォトニック材料としてさまざまな機能をもつ化合物半導体やゲルマニウムとの融合を図る研究に取り組んできた(2011年6月12日、2011年9月27日産総研プレス発表)。今回、産総研による世界屈指の基板貼り合わせ技術とデバイス作製技術、住友化学の商用レベルの化合物半導体エピタキシャル成長技術を利用し、ポストシリコンデバイスとシリコンデバイスの機能集積に向けた高性能半導体結晶の貼り合わせと低温デバイス作成技術の開発に成功した。
バックエンド集積化とは、シリコンウエハーにSi-LSIなどを形成する工程(フロントエンドプロセス)ではなく、トランジスタなどの素子間を配線する工程(バックエンドプロセス)において、機能デバイスを形成し、下部にあるSi-LSIと接合することで、Si-LSI機能に新たな機能を加えることである(図1)。これまでの研究で、ポストシリコン材料は、デバイス作製時の温度が1000℃超えるシリコン材料と比較すると400℃以下と低いため、最高でも500℃程度の低温プロセスを求められるバックエンドプロセスでのデバイス作製に適していることがわかっている(2011年6月12日、産総研プレス発表)。また、プロセス温度の低温化は、今まで無機系材料が中心であった半導体デバイスプロセスに、安価で機能性に富むポリマー材料の導入を可能にしている。今回、極薄(300 nm以下)のポストシリコン材料を、ポリイミドを使ってシリコン上に転写し、ポリマーに直接接合した半導体層を使って400℃以下の温度でトランジスタを作製した。極薄半導体活性層にポリイミドを直接接合させ、シリコンの性能を凌駕するトランジスタの作製と動作実証をしたのは世界で初めてである。
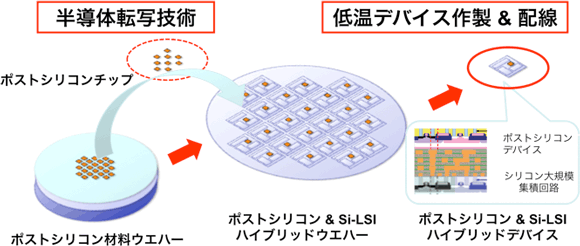 |
|
図1 ポストシリコン材料バックエンド集積化技術 |
図2に今回開発したバックエンド集積化型高性能トランジスタの作製方法を示す。まず、ポストシリコン材料として高品質なInGaAs層(300 nm)を、格子整合するリン化インジウム(InP)基板上にエピタキシャル成長させる(図2(a))。次に、接着用ポリイミドをスピンコーティング法で塗布したシリコン基板とエピタキシャル成長した基板とを反転接合させる(図2(b))。今回、ポストシリコン材料の貼り合わせのために、450℃以上の耐熱性(図3 )と高い接着性を併せ持つポリイミドを新たに開発した。次にInP基板を選択的にはく離し、シリコン基板上の薄膜InGaAs結晶層を得た(図2(c))。最後に、作製されたポリイミド/シリコン基板上のInGaAs結晶層を利用して、400℃以下のプロセス温度でトランジスタを形成した(図2(d))。ポリイミドは、接合剤として極めて安価で扱いやすい点が大きなメリットであり、今回、このポリイミドを使って転写プロセスやトランジスタ作製プロセスでの耐性を検証した。
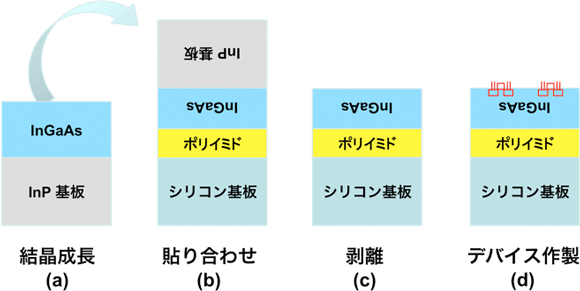 |
|
図2 ポリマー上のトランジスタ作製方法 |
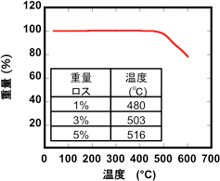 |
図3 接合に用いたポリイミドの物性
500 ℃前後まで重量のロスがほとんどない。 |
図4にポリイミド上に形成されたゲート長50 µmのInGaAs n型MOSFETの性能を示す。ドレイン電流—ゲート電圧特性からはオン・オフ比が二桁以上の良好なスイッチング特性、ドレイン電流—ドレイン電圧特性から明瞭な線形領域と飽和領域が観察され、良好なトランジスタ動作をしていることが確認された(図4 左図と中央図)。図4 (右図)は、転写する前のInP基板上とポリイミド上のInGaAsの移動度特性の比較である。ポリイミド上でも、移動度が最高で1000 cm2/Vsを超えており、シリコンの移動度の約2倍近い値を示している。InP基板上と比較しても、低キャリア密度領域でわずかに移動度減少が見られるものの、高キャリア密度領域では完全に一致している。トランジスタ形成時に、ポリイミドはさまざまな熱サイクル、さらには化学的な処理に曝されるため、当初はプロセス中の汚染源としてトランジスタ性能劣化の要因になることが懸念されたが、今回の結果は、ポリイミドがポストシリコン半導体向け基材として十分に機能していることを示している。また、転写前後でデバイス特性に大きな劣化は見られないことから、転写プロセスが半導体層に悪影響を与えていないことがわかった。今回、ポリイミドを使った転写技術とポストシリコン材料の低温トランジスタ作製技術が実証されたことから、バックエンドプロセスでのポリマー材料の導入とポストシリコンデバイスのSi-LSIとの集積化が容易に可能となる。今後、ポリイミドとポストシリコン材料の多様性を活かした高性能・多機能デバイスの実現が期待される。
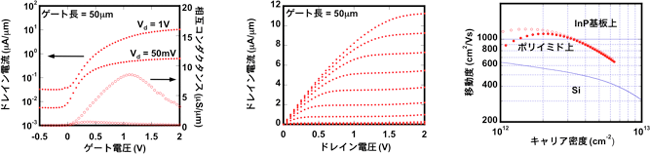 |
|
図4 ポリイミド上のInGaAs n型MOSFETの性能
オン・オフ比二桁以上の良好なスイッチング特性(左図)。明瞭な線形領域と飽和領域が観察される(中央図)。ポリイミド上の移動度はシリコンの約2倍(右図)。 |
今後、InGaAsをはじめとしたポストシリコン材料がさまざまな分野、環境で使用される可能性がある。例えば、エレクトロンデバイスとフォトニックデバイスのワンチップ化など、これまでの技術では不可能であった高性能化、多機能化そして集積化が期待される。また、今回プロセス耐性を検証したポリイミドは、感光性能を付加できるため、任意の場所にポリイミドを形成したり、配線用の微細な2次加工を施すなど、高度な3次元積層集積化にも極めて有効であると考えられる。今後はさらなるポストシリコン材料のバックエンド集積技術の高度化に向けて、ポストシリコン材料を必要な場所に必要な大きさを供給し、高性能・多機能デバイスを作製する技術を開発する予定である。