独立行政法人 産業技術総合研究所【理事長 中鉢 良治】(以下「産総研」という)集積マイクロシステム研究センター【研究センター長 前田 龍太郎】ライフインターフェース研究チーム【研究チーム長 亀井 利浩】小林 健 主任研究員は、大日本印刷 株式会社【代表取締役社長 北島 義俊】(以下「大日本印刷」という)研究開発センター 次世代MEMS研究所【所長 鈴木 浩助】森脇 政仁 研究員、瓜生 敏文 研究員と共同で、圧電薄膜であるチタン酸ジルコン酸鉛(Pb(Zr,Ti)O3、PZT)薄膜を用いた圧電MEMSデバイスの200 mmウエハープロセス技術を開発した。
PZT薄膜を用いた圧電MEMSデバイスはインクジェットヘッド、ジャイロセンサーを中心に100 mm、150 mmウエハープロセスで製造されている。しかし、PZT薄膜形成の難しさから200 mmウエハープロセス化が進まず、低コスト化の障壁となっていた。今回、200 mmウエハーにPZT薄膜を形成できる自動ゾルゲル形成装置を開発するとともに、歩留まり低下の原因となる粗大粒子の生成をウエハーあたり20個以下に抑制できる薄膜形成条件を見いだした。また、産総研が保有するMEMS製造ラインを用いて、圧電MEMSデバイスの200 mmウエハープロセス技術を確立した。圧電MEMSデバイス作製後に直流電圧を加えるポーリングをすることで、d31=-90 pm/V(-2~+2 V駆動時)と実用レベルの圧電定数を実現した。
この成果の詳細は2014年1月29日~31日に東京ビッグサイト(東京都江東区)で開催される第13回国際ナノテクノロジー総合展・技術会議(nano tech 2014)にて発表される。
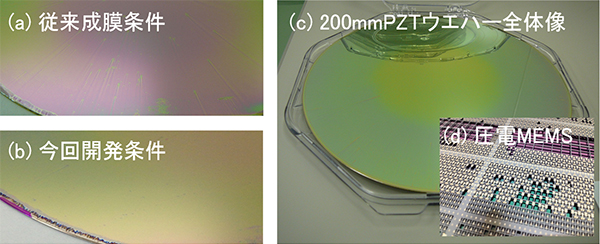 |
|
(a)従来の条件で形成したPZT薄膜、(b)今回開発した条件で形成したPZT薄膜(粗大粒子をウエハーあたり20個以下に低減)、(c)PZT薄膜を形成した200 mmウエハーの全体像、(d)圧電MEMSデバイスの200 mmウエハープロセス技術により作製した圧電MEMSデバイス。 |
PZT薄膜を用いた圧電MEMSデバイスは、既に製品化されているインクジェットヘッド、ジャイロセンサーの市場拡大や、振動発電素子、静電気センサーなどの新規デバイスの実用化の進展に伴い、需要が増大すると予想されている。このため、圧電MEMSデバイスの製造に用いられている100、150 mmウエハープロセスを200 mmウエハープロセスへ大口径化して、製造能力の向上や低コスト化が求められている。しかしながら、200 mmウエハー上にPZT薄膜を均一に形成することが難しいため、200 mmウエハープロセス化は実現されていなかった。
産総研は、ゾルゲル法によるPZT薄膜の形成や、これを用いた圧電MEMSデバイス作製の100 mmウエハープロセス技術を確立しており、企業と共同で図1に示すような静電気センサー、振動発電素子、超音波センサーなど、さまざまな圧電MEMSデバイスの研究試作を行っている。近年、200 mmウエハープロセス化への要求が高まりつつあり、研究試作から量産へのスムーズな移行ができる体制が求められている。一方、大日本印刷は200 mmウエハープロセス技術によるMEMSデバイス開発に多数の実績を有している。そこで産総研は大日本印刷と共同で200 mmウエハーを用いた圧電MEMSプロセス技術の開発を行った。
なお、この研究開発は、総合科学技術会議により制度設計された最先端研究開発支援プログラム(平成21~25年度)により、独立行政法人 日本学術振興会を通して助成された研究課題「マイクロシステム融合研究開発(中心研究者:江刺 正喜 東北大学教授)」の中で行われた。
 |
図1 開発中の圧電MEMSデバイス
(a)静電気センサー、(b)振動発電素子、(c)超音波センサー |
産総研は、100 mmウエハープロセスで行う研究試作から、200 mmウエハープロセスで行う量産試作へのスムーズな移行のために、100、150、200 mmウエハーにPZT薄膜を同一条件で形成できる自動ゾルゲル形成装置を開発した。これまで研究試作で100 mmウエハーに形成していた条件では、歩留まり低下の原因となる粗大粒子(直径5 µm以上)が200 mmウエハー上に300個以上生成していた。そこで、形成時の雰囲気や熱処理条件を工夫することで、良好な圧電特性に有利な(100)/(001)結晶配向性を維持しながら、200 mmウエハーあたりの粗大粒子の数をこれまでの300個以上から20個以下に低減したPZT薄膜を形成できた(図2)。これにより圧電MEMSデバイスの歩留まりが大幅に向上可能となる。
 |
図2 (a)粗大粒子が溶液塗布時のムラとして現れている従来の形成条件のPZT薄膜表面、(b)今回の開発条件で形成したPZT薄膜表面、(c)今回開発の条件で形成したPZT薄膜のX線回折図形
(a)と(b)の矢印の先の青点は、ウエハー表面検査装置で測定した粗大粒子分布測定結果。(c)のPt(111)は下地電極に由来する回折ピーク。 |
このPZT薄膜を形成した200 mmウエハーを、圧電MEMSデバイスに微細加工するプロセス技術を、大日本印刷と共同開発した(図3)。作製した圧電MEMSデバイス上のPZT薄膜に、電界強度100 kV/cmの直流電圧を印加することで、圧電定数d31で-90 pm/V(-2~2 V駆動時)、-140 pm/V(0~20 V駆動時)と実用レベルの圧電定数をデバイスの状態で実現できた。
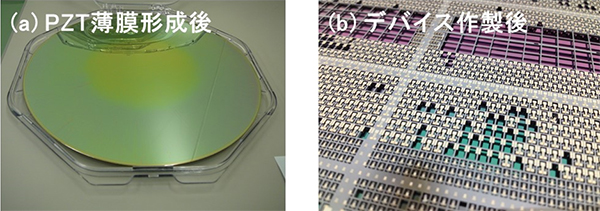 |
|
図3 (a)PZT薄膜を形成した200 mmウエハーと(b)200 mmウエハーで作製した圧電MEMSデバイス |
今後は200 mmウエハー面内でのPZT薄膜の均一性を向上させるとともに、研究試作が完了した圧電MEMSデバイスの量産試作を行っていく。また、100 mmウエハーでの研究試作から200 mmウエハーでの少量生産までを可能とする、企業のニーズに即した研究開発支援体制の構築を目指す。