独立行政法人 産業技術総合研究所【理事長 中鉢 良治】(以下「産総研」という)ナノエレクトロニクス研究部門【研究部門長 金丸 正剛】連携研究体グリーン・ナノエレクトロニクスセンター【連携研究体長 横山 直樹】入沢 寿史 特定集中研究専門員らは、国立大学法人 東京工業大学【学長 三島 良直】(以下「東工大」という)電子物理工学専攻 宮本 恭幸 教授、住友化学株式会社【代表取締役社長 十倉 雅和】(以下、「住友化学」という)と共同で、新構造の採用により性能を従来から2倍向上させたインジウムガリウムヒ素(InGaAs)トランジスタを開発した。
四角形断面を持つInGaAsの立体構造上に、適切な条件でInGaAsを再成長させて、両斜面が(111)B面である三角形断面の立体構造を作製した。この立体構造をチャネルとしたトランジスタは、(111)B面に起因する高移動度と、再成長時の表面平坦化により、従来のInGaAsトランジスタの2倍の電子移動度を示した。これにより、トランジスタの動作電圧を下げられるので、従来の四角形断面構造に比べ、集積回路の消費電力が最大で6割程度低減することが期待される。
なお、この技術の詳細は、平成25年12月9~11日(現地時間)に米国ワシントンD.C.で開催されるInternational Electron Device Meeting (IEDM)で発表される。
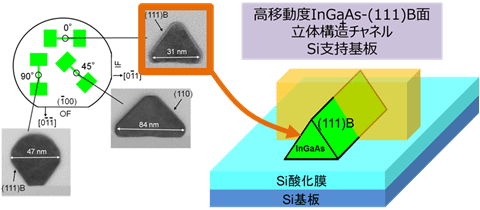 |
|
(111)B面を持つ三角形断面チャネルのInGaAsトランジスタの概念図 |
携帯情報端末の爆発的な普及やIT機器の高機能化に伴う消費電力の増大により、電子情報機器の消費電力低減が求められている。そのためには、これらに搭載されている大規模集積回路(LSI)を構成する個々のトランジスタに供給する電圧(電源電圧)を低くすることが重要である。これまで、電源電圧は徐々に下げられてきたが、近年、1 V程度で飽和しつつあり、2016年の予測でも0.8 V~0.6 Vに留まる。これは、従来のトランジスタの材料であるシリコン(Si)の物性や平面型のトランジスタ構造による限界に近づいてきたためである。そこで、Siより電子の移動度の高いInGaAsなどのⅢ-Ⅴ族化合物半導体を導入し、さらに、FinFETなど、立体的なゲート構造を採用して上記限界を下回る電源電圧を達成するための研究開発が活発化している。
連携研究体グリーン・ナノエレクトロニクスセンター(GNC)は、内閣府と独立行政法人 日本学術振興会によって運営される最先端研究開発支援プログラム(FIRST)に採択されたプロジェクトを実施するために平成22年4月に設立された。企業5社(富士通株式会社、株式会社 東芝、株式会社 日立製作所、ルネサスエレクトロニクス株式会社、株式会社 アルバック)からの出向研究者と産総研研究者によって構成されている。GNCでは平成23年度より、LSIの低電圧動作を目指して、高移動度材料であるゲルマニウム(Ge)やInGaAs を用いたMOSFETの高性能化に関する研究開発を行ってきた。
なお、本研究成果は、FIRSTのプロジェクト「グリーン・ナノエレクトロニクスのコア技術開発」の助成により得られたものである。また、InGaAs基板の開発、作製は住友化学との共同研究により行った。さらに、InGaAs再成長による三角形断面のチャネルの形成は東工大 宮本 恭幸 教授との共同研究により行った。
通常、InGaAs基板の表面の面方位は(001)面であるが、(111)A面を用いると電子移動度が高くなることが報告されていた。今回、エピタキシャル成長時に(111)A面より出現しやすい(111)B面上の電子移動度が(001)面上より大きくなることを発見した。トランジスタの電流駆動力増大に有利な(111)B面の利用を、オフ時のリーク電流を抑制するための立体チャネル構造と組み合わせるため、図1に示すような三角形断面のチャネルを持つトランジスタを作製した。初めに(001)リン化インジウム(InP)基板の(001)面上にInGaAs薄膜をエピタキシャル成長させ、Si基板上の絶縁膜に貼り合わせた。塩酸によってInP基板だけを選択的にエッチングすると、通常の(001)表面を持つInGaAs薄膜が残る。この薄膜を微細な長方形断面の立体構造(InGaAs-fin)に加工したのち、その上に、適切な条件でInGaAsをエピタキシャル成長させると、両斜面が(111)B面である三角形断面の立体チャネル構造が得られた。この時、下地の絶縁膜上にはInGaAsが成長せず、InGaAs-fin上にだけ選択的に成長させることができた。
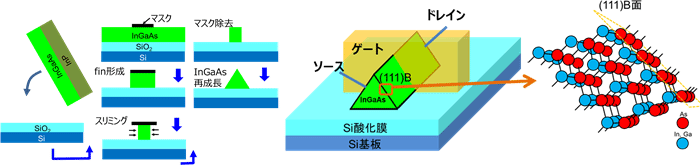 |
|
図1 InGaAs-fin上への再成長による(111)B面三角形断面チャネルの形成 |
当初、InGaAs-fin上にはリソグラフィーやエッチング工程に起因する幅の不均一が存在したが、InGaAsの成長過程で平坦化されることも分かった(図2)。(111)B面上の成長速度が他の面上より遅く、(111)B面が広範囲に形成されるため、平坦化されると考えられる。なお、InGaAs-finの向きにより、表面が(110)面である類似の立体構造も形成されるが、(111)B面上の移動度の方が高かった(図3)。
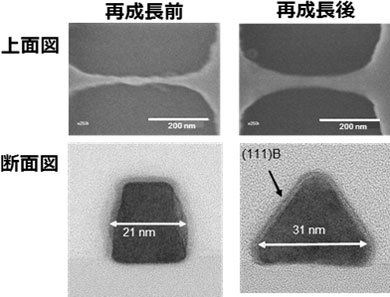 |
|
図2 (111)B面の形成による表面平坦化 |
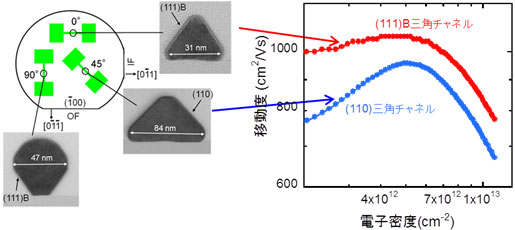 |
|
(a) |
(b) |
|
図3 (a)InGaAs-finの向きによる立体構造の変化、(b)(111)B面三角形断面チャネルと(110)面三角形断面チャネルの移動度 |
この(111)B面三角形断面チャネル上にゲート絶縁膜(酸化アルミニウム、Al2O3)とゲート電極(窒化タンタル、TaN)を形成し、ニッケル(Ni)-InGaAs合金のソース、ドレイン電極を形成した。図4(a)に示すように、動作電圧相当の電子密度(~1×1013 cm-2)では、従来の四角形断面チャネルのInGaAs-FinFET(従来型FinFET)の2倍の電子移動度が得られた。移動度が増大したため、図4(b)に示すように、チャネル長が300 nmのトランジスタでは電流が72 %増大した。これにより、同一の動作速度を得るための電圧を、従来型FinFETより低くできるので、電圧の2乗に比例する動作時の消費電力を大幅に低減することができる。例えば、電圧1 V動作の従来型FinFETに比べて、消費電力を最大で57 %低減できる。また、ノイズも従来型FinFETに比べて5分の1程度に低減した。このような移動度の向上やノイズの低減は、(111)B面の高移動度と、図1に示したような、表面平坦化の効果と考えられる。さらに、この表面平坦化は、トランジスタの電気特性のばらつき抑制にも寄与することが期待される。
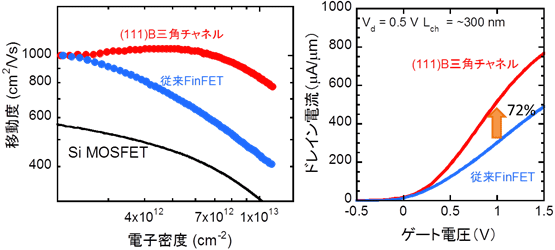 |
|
(a) |
(b) |
|
図4 (a)従来型FinFETと、(111)B面三角形断面チャネルの移動度、(b)チャネル長300nmのトランジスタの電流駆動力(しきい値電圧を揃えて比較してある) |
今後はp型トランジスタの高性能化に適したゲルマニウム(Ge)の立体チャネルトランジスタと組み合わせ、CMOS回路としての動作を検証していく。トランジスタ単体の性能だけでなく、Si-CMOS回路を上回る回路性能、あるいは低消費電力化を目指す。