独立行政法人 産業技術総合研究所【理事長 中鉢 良治】(以下、「産総研」という)先進パワーエレクトロニクス研究センター【研究センター長 奥村 元】ウェハプロセスチーム 加藤 智久 研究チーム長は、太平洋セメント株式会社【代表取締役社長 福田 修二】(以下、「太平洋セメント」という)および屋久島電工株式会社【代表取締役社長 下泉 学】(以下、「屋久島電工」という)と共同で、パワー半導体用炭化ケイ素(SiC)バルク単結晶の高速成長を可能とする昇華法用高純度SiC粉末原料を開発した。
今回、SiC原料粉末からの昇華ガスの発生しやすさに着目し、ガスの透過性を利用した空気透過法(ブレーン法)を用いて、現状の製造工程での温度条件を大きく変えずに成長速度を約 2倍に向上させることが可能となる粒子形状を有した高純度SiC粉末原料を開発した。開発したSiC粉末原料を従来のSiC粉末原料と置き換えるだけでSiCバルク単結晶の高速成長が可能となり、高温工程の時間短縮によるコスト低減・工程の簡素化ができる。また本粉末の製造法は、従来のSiC研磨材の量産技術であるアチソン法を元に改良したもので、高純度化に加え高い量産性を持つことも特徴である。
この技術の概要は、2013年12月9日~12月10日に、埼玉県さいたま市で開催される「SiC及び関連半導体研究 第22回講演会」で発表される。
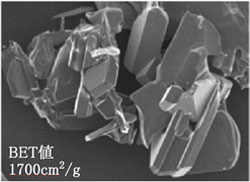 |
|
昇華法用高昇華型SiC粉末原料 |
資源・エネルギーの問題を解決するためには、自然エネルギーの有効活用とともに、省エネルギー技術、高効率利用技術および低損失化技術が重要となる。現在、電気エネルギーの効率的な利用・制御および効率的な動力への変換・制御を行うために、半導体からなるパワーデバイスを用いた電力制御・変換技術が活用されている。このパワーデバイスとしては、主としてシリコン(Si)半導体が使われているが、Si半導体は電力の変化効率(低損失化)において半導体の特性上限界を迎えつつあり、さらなる効率化・低損失化を実現するには、Siに代わる新しい半導体材料を用いたパワーデバイスの開発が求められている。その代表がSiCであり、次世代パワーデバイス用半導体材料として注目されている。
このSiCパワーデバイスは、既にSBDやMOSFETが実用化されており、今後、その市場は大きく拡大していくと考えられているが、その市場の拡大を加速させるには、デバイスに使われるSiC基板の低コスト化が必須である。SiC基板の低コスト化を図るには、SiCバルク単結晶(インゴット)の生産性を高めることが重要な課題となる。SiCインゴットは、SiC粉末原料を約2,400 ℃の高温で昇華させ、再析出させる昇華再結晶法(改良Lely法)で製造される。このため、この製造法におけるSiCインゴットの生産性は、原料となるSiC粉末の昇華特性に大きく影響を受けると考えられ、生産性を高めるために昇華速度、昇華ガス量などが優れたSiC粉末材料が求められている。
産総研では、1970年代から次世代パワー半導体材料としてのSiC半導体の研究に取り組んできており、昇華再結晶法によるSiCバルク単結晶成長技術開発では、2002年に世界に先駆けΦ4インチ長尺単結晶の成長に成功、2013年には低損失パワーデバイスに貢献する積層欠陥のない高品質低抵抗n型SiCバルク単結晶を成果として報告した。
SiCバルク単結晶成長法の昇華再結晶法は現在のSiCウエハー量産技術として既に確立しているが、結晶成長速度が遅いため、SiC単結晶インゴットの製造コストが非常に高いという問題があった。今後のSiCパワーデバイスの研究開発、量産化を一層促進するには、材料コストを大きく改善できる新しい結晶成長技術の確立が重要となる。SiC単結晶インゴットの量産効率を改善するには単結晶成長速度の高速化が最も重要となる。昇華再結晶法における単結晶成長速度は炉内の温度勾配によって制御が可能である。しかし、高い成長速度を得るために大きな温度勾配を付けると成長条件が合わなくなり、結晶多型の異常や結晶内部ひずみの増加、結晶欠陥の増加などのさまざまな問題が発生する。そのため、現状の量産技術でも結晶成長速度は500 µm/h程度と、シリコン単結晶の20分の1以下の成長速度で限界となっている。また、昇華法による単結晶成長では2,000 ℃を超える高温工程が必須であり、その継続時間は製造コストに直結し、時間の短縮が大きな課題であった。このような背景から、結晶成長技術、粉末製造技術を融合させ、SiCバルク単結晶の生産能率を改善する新しいSiC粉末原料の開発に着手した。
昇華再結晶法におけるSiCバルク単結晶の成長速度は炉内の昇華原料ガスの過飽和度、すなわち炉内の温度勾配によって制御が可能である。一般に、粉末原料の表面から昇華ガスを発生させる場合、その粉末の比表面積が大きくなる程(粒径が細かくなる程)、単位時間当たりのガス発生量は増大する。しかし、昇華再結晶法では粉末原料を黒鉛るつぼに充填して使用することから、粒径を細かくすることで粉末充填後のるつぼ内の空隙率が小さくなり、昇華ガスがかえって発生しにくくなる傾向がある。一般に充填粉末の比表面積と粉末を充填したるつぼ内の空隙率は互いに背反の関係になる傾向があるため、それらのバランスの良いところで昇華ガスの発生効率は極大値を持つことになる(図1)。BET法での測定で比表面積を調べたところ、1,600~1,700 cm2/g付近で2,400 ℃付近の昇華効率が最も高くなることを昇華実験で確認した。
 |
|
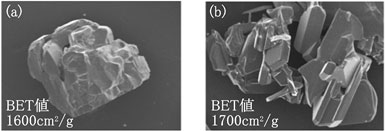 |
|
図1 昇華法におけるSiC原料粉末の比表面積と昇華速度の関係 |
|
図2 ほぼ同じ比表面積(BET値)を有する(a)アチソン粉体、および(b)開発SiC粉体の拡大写真 |
そこで充填原料のガスの通りやすさを改善するSiC粉末の合成を試みた。昇華法ではアチソン法によって合成したSiC結晶を粉砕した粉末を簡便に原料として使うケースが多いが、単結晶の粉砕であるため粉体の形状が等方的で緻密な構造をしている。図2(a)はそのアチソン粉体の拡大写真である。一方、図2(b)は今回の研究で新たに合成を試みたSiC粉体である。この粉体はBET法による比表面積が前者のアチソン粉体とほぼ同じ1,700 cm2/gを示しているが、板状に発達した小さな結晶粒が複数融合した形状をしている。
これら2者の形状の違いを把握するためにガスの透過性を利用した空気透過法(ブレーン法)によって比表面積を測定・評価した。ブレーン法とは粉体充填層における流体の透過性から、その粉体の比表面積を計測する手法であり、値が大きいほど、粒子形状が複雑で、ガスの通過経路が多いことを意味している。その結果、本研究で開発したSiC粉末は、ブレーン法を用いるとアチソン粉体の約2倍差の比表面積540 cm2/gを示すことがわかり(表1)、アチソン粉体を充填した場合に比べ、昇華ガスが発生しやすく、ガスの通過経路が多いことにより発生したガスが通過しやすくなると想定できる。
そこで、これら粉末を使って昇華特性の比較実験を行った。実験はアチソン粉体、開発SiC粉体をそれぞれ黒鉛製のふた付きるつぼ(内径100 mm)に同一量を装填し、るつぼ下部を約2,250 ℃、るつぼ上部を約2,150 ℃と勾配を設けて加熱し、昇華率を計測した。加熱炉は通常のSiC結晶成長で利用する昇華炉を用い、アルゴン(Ar)雰囲気中の同一圧力、加熱条件で実施した。実験の結果、原料の充填量に対しアチソン粉体の昇華率は8.1 %/hであったが、開発したSiC粉体は17 %/hと約2倍の昇華率を示した(表1)。これは従来と同一の成長条件において、原料を入れ替えるだけで少なくとも2倍の結晶成長速度増加(生産能率)が見込めることを示している。
一方、高い昇華率は低抵抗n型・p型半導体を得るための不純物添加制御にも優位性がある。図3は高速成長させた低抵抗n型SiCバルク単結晶の例である。昇華法による成長は炉内を減圧制御して実施するのが一般的で、圧力の減少に伴い成長速度を上げることができる。しかし、成長速度が上げられる反面、不純物が添加されにくくなる。パワーデバイスの電力低損失化にはSiCウエハーの低抵抗化が必須であるが、このような成長条件上の問題から量産性維持と低抵抗化の両立がバルク単結晶成長技術の課題の一つであった。今回、昇華率の高いSiC原料粉末を開発したことによって、高濃度不純物添加と高速成長を両立した低抵抗SiCバルク単結晶を得られるようになった。結晶成長速度は最大2.2 mm/hまで確認している。
|
表1 図2で示した各粉体の真密度、比表面積、および昇華特性 |
 |
 |
|
図3 高速成長した高品質n型SiCバルク単結晶 |
今後は、単結晶製造における実用レベルの応用技術開発やさらなる高品質・高速成長を可能とする技術開発を推し進める予定である。また、開発したSiC粉末についてはサンプル出荷を計画中である。