独立行政法人 産業技術総合研究所【理事長 野間口 有】(以下「産総研」という)計測標準研究部門【研究部門長 岡路 正博】温度湿度科 放射温度標準研究室 山田 善郎 主任研究員、石井 順太郎 研究室長は、株式会社 半導体先端テクノロジーズ【代表取締役社長 渡辺 久恒】(以下「Selete」という)、大日本スクリーン製造株式会社【代表取締役 取締役社長 橋本 正博】(以下「SCREEN」という)、株式会社 チノー【代表取締役社長 苅谷 嵩夫】(以下「チノー」という)と共同で、シリコンウェハの高速光アニール(以下「フラッシュランプアニール」という)装置向けの表面温度モニタリングシステムを開発した。
今回開発した技術は、強力な加熱用キセノンランプ光源の発光およびウェハ表面の放射率挙動の影響を排除し、1000 ℃付近まで温度が上昇するウェハの表面温度変化を、非接触で正確かつ高速に測定するものである。本表面温度モニタリングシステムをフラッシュランプアニール装置に搭載すると、0.001秒程度で高速に昇降温する表面温度変化を、その場測定することができる。この技術は、シリコンデバイスの微細化技術の高度化に貢献するとともに、産業分野における各種高温プロセス温度モニタリング技術としての応用が期待できる。
本技術の詳細は、2009年10月7日~9日に、仙台市で開催の国際固体素子・材料コンファレンス(2009 International Conference on Solid State Devices and Materials: SSDM 2009)で発表される。
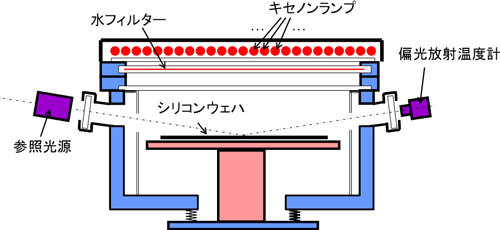 |
|
フラッシュランプアニール装置と温度モニタリングシステムの概要図
|
シリコンデバイスの微細化実現のための技術として、注入ドーパントの活性化や、不純物の拡散制御を行う高速加熱処理(RTA: Rapid Thermal Annealing)技術の高度化が必要とされている。そのため、例えば、先進的なRTA技術であるフラッシュランプアニール法では、ウェハ表面を0.001秒程度の短時間に1300 ℃付近にまで昇降温する処理が行われる。処理条件の最適化には、0.001秒以下での加熱時間の制御、加熱温度の数℃レベルでの制御が必要となり、加熱処理中のウェハ表面の温度変化を「その場」において観測できる新たな計測技術開発が求められてきた。
産総研では、熱放射を利用した温度測定(放射温度計測)技術、そのための国家標準の開発、供給に関する研究を推進している。放射温度計測は、非接触で物体表面の温度を測定する方法として、産業・科学分野において広く利用されている。一方、温度に応じて放出される赤外光あるいは可視光を利用する測定法であるため、物体表面の特性(放射率)に依存することや周囲環境からの光(背景放射光)などの影響を受け、測定の信頼性が低下することが技術的課題となってきた。
今回、産総研では、偏光反射測定を利用した放射率補正法、および、加熱に用いるフラッシュランプからの背景放射光を低減する技術を提案し、Selete、SCREEN、チノーと共同で、フラッシュランプアニール装置に適用可能で、測定信頼性の高いウェハ表面温度モニタシステムを開発した。
フラッシュランプアニール法でのウェハ表面の温度計測には、1000 ℃以上までの高温測定、高速な温度変化を0.001秒以下の測定間隔で追跡できること、さらには非接触・その場計測であることが要求される。これらの条件を満たす要素技術として、赤外放射温度計が有望である。しかしながら、実際のフラッシュランプアニール装置において赤外放射温度計を用いるには、加熱用の強力なキセノンランプの発光が背景放射光となること、温度変化によりウェハ表面の特性(放射率)が変化すること、の2つの問題を解決することが必要であった。
今回開発したシステムでは、キセノンランプによる背景放射光の対策として、キセノンランプとウェハの間に水フィルター膜を設置した。これは、水が赤外光の一部(水の吸収線波長帯)を吸収する特性を利用し、キセノンランプの光成分のうち、赤外光の一部を除去し可視光を透過させるものである。シリコンウェハは可視光を吸収し加熱されるため、キセノンランプの加熱光源としての機能を損なうことはない。一方、赤外放射温度計の観測波長帯を水の吸収線波長帯と良く一致させることにより、キセノンランプの発光の影響を受けず正確な温度測定が可能となった。
また、温度変化によりウェハ表面の放射率が変化するという問題を解決するため、偏光反射測定を利用した放射率補正法を導入した。放射温度測定と反射率測定を高速に同時に行うため、偏光検出型の高速赤外放射温度計と高速(0.001秒以下)で点滅可能な高輝度参照光源を開発した。赤外放射温度計は、p偏光(ウェハ表面に対して垂直な成分)、s偏光(ウェハ表面に対して平行な成分)のそれぞれの強度を測定でき、参照光源の消灯時にはウェハ表面からの熱放射を測定し、点灯時にはウェハ表面で反射した参照光源からの光が加わったものを測定する。これにより、熱放射および反射光のp偏光、s偏光成分が得られ、ウェハ表面の放射率の決定とともに、熱放射の強度も測定でき、両者から放射率補正を行ったウェハ表面の温度測定が可能となっている。
以上のような計測技術により測定した、フラッシュランプ加熱中のシリコンウェハ表面温度変化の測定結果を図に示す。
 |
|
図 フラッシュランプアニール装置で加熱中のウェハ表面温度の実測値
|
0.001秒程度の間に、ウェハ表面温度が1100 ℃以上まで昇温し、その後急速に温度低下している様子が、実測データとして確認できる。
今回開発した温度モニタシステムは、SCREENおよびチノーにおいて、実用化・製品化に向けた技術開発が進められている。
また、今回開発した温度計測技術については、フラッシュランプアニール法以外のシリコンプロセスをはじめとして、各種産業分野における高温プロセス用温度モニタ技術としての展開を目指している。