独立行政法人 産業技術総合研究所【理事長 吉川 弘之】(以下「産総研」という)ナノテクノロジー研究部門【研究部門長 南 信次】先進ナノ構造研究グループ 秋永 広幸 研究グループ長、島 久 研究員は、シャープ株式会社(以下「シャープ」という)と共同で、低消費電力、高速動作の性能を兼ね備えた不揮発性の抵抗変化メモリー素子(Resistance Random Access Memory : RRAM)の開発に成功した。
これまで、RRAMは次世代超大容量メモリー候補として期待されていたが、今回、メモリー実用化に必須である低消費電力、高速動作が実証されたことにより、その実現に向けた途が拓かれた。今回開発したRRAMは、タンタル(Ta)電極とコバルト(Co)酸化物からなる極めて単純な金属/酸化物接合を基本構造としている。当共同研究グループは、この接合界面におけるナノメートルスケールでの電気化学反応を定量的に制御することによってメモリー動作の高性能化を実現した。また、このRRAMの作製方法は、既存の半導体製造プロセスとの整合性が高い。さらに、貴金属電極など高価な部材や特殊な取り扱いを必要とする原料も用いていないことから、開発したRRAMはビットコスト競争力に優れるだけでなく、省エネルギー・省資源も実現するメモリーである。
今後、大容量の情報を高速にやり取りする機能を持つ素子の重要性がますます高まってきている情報・エレクトロニクス分野において、今回開発されたRRAMが省エネルギーの鍵となる次世代不揮発性メモリー素子となることが期待される。
なお、本研究は、独立行政法人 新エネルギー・産業技術総合開発機構(NEDO)の委託を受けて行ったものである。本研究成果は、2008年9月26日に、つくば国際会議場(茨城県つくば市)で開催される国際固体素子・材料コンファレンスで発表される。
|

|
|
競合が想定される既存のメモリーであるNOR型フラッシュメモリーと比較して、ビットあたりで1000分の1以下の消費電力にて動作する。 |
大容量の情報を高速に処理することが不可欠になる中で、次世代のメモリー素子として超大容量、低消費電力、高速処理が可能な素子の開発が望まれている。
RRAMは、遷移金属酸化膜を金属電極で挟んだ構造で、その酸化膜の電気抵抗変化を記憶情報とするメモリー素子であり、低消費電力で、大容量データを高速書き換えできる次世代メモリーとして期待されている。これらの特長を兼ね備えることにより、初めて次世代デジタルAV機器などへの幅広い適用が可能となる。しかし、RRAMの遷移金属酸化膜の抵抗変化を定量的に制御する方法は開発されておらず、その特長を活かした素子の実現が困難であった。
1997年、アトムテクノロジー研究体(JRCAT)にて、3元系ペロブスカイト型遷移金属酸化物における電界誘起抵抗変化現象が発見された。この研究に触発されて電界誘起抵抗変化の研究が始まり、2002年にシャ-プとヒューストン大学が、3元系ペロブスカイト型遷移金属酸化物を用いたメモリーを初めて発表した。さらに、2004年頃からは、2元系遷移金属酸化物を用いた抵抗変化メモリーの発表が多くなり、現在の半導体テクノロジーと整合性が良いことから大きな注目を集めるようになった。
一方、2000年、JRCATにて、金属・絶縁性半導体ハイブリッド構造における抵抗スイッチ現象が発見され、その後、NEDOナノ機能合成技術プロジェクトにおいて、抵抗スイッチ現象の起源解明と応用研究が行われた。同プロジェクト終了後、抵抗スイッチ現象のメモリー応用の研究が、産総研、シャープ、株式会社アルバック、および大阪大学の垂直連携によるNEDOナノテク・先端部材実用化研究開発(ナノテクチャレンジ)に引き継がれ、現在に至っている。
このような中で、シャープと産総研は、2006年末、RRAM素子の抵抗変化現象において情報が記憶される抵抗変化部分以外の抵抗成分に注目し、それ以前には制御していなかったこの抵抗成分を情報の書き込み時・消去時に異なる値にすることでそれぞれの動作を高速化することに成功した。読み出し・書き換え時間は、それぞれ10ナノ秒(1/100,000,000秒)程度であり、これは高速動作を特徴とする磁気抵抗ランダムアクセスメモリー(MRAM)に匹敵する。しかしながら、低電流動作と高速動作を同時に満たすこと、またRRAM動作を定量的に制御することはできていなかった。
今回の開発では、固体化学の知識を援用して金属電極と酸化物材料の組み合わせの最適化を図り、さらに、その界面にナノメートルスケールのTa酸化物界面層を形成することによって低電流動作と高速動作を両立させるとともに、動作電流(すなわち、オン・オフそれぞれの状態における素子の抵抗値)を制御する手法を開発することに成功した。
図1に今回開発したRRAMにおける書き換え動作を示す。Co酸化物層からナノメートルスケールのTa酸化物層に酸素が移動するとメモリー素子の抵抗は小さくなる。逆に、Ta酸化物層からCo酸化物に酸素が移動して界面の状態が元に戻るとメモリー素子の抵抗は大きくなる。
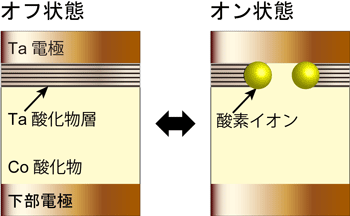 |
|
図1:RRAM動作の説明図
導電性のあるコバルト(Co)酸化物が電極にサンドイッチされていて、陽極側のタンタル (Ta)電極との界面にはTa酸化物層が形成されている。メモリー動作は、Co酸化物とTa 酸化物層との間で酸素イオンのやり取りによって行われる。電圧パルスにより陽極側の Ta酸化物に導電経路が形成されると、電極間の抵抗は下がりメモリーはオン状態となる (右図)。電流誘起の酸化反応が起きるとその導電経路がふさがって、電極間の抵抗は上 がりメモリーはオフ状態となる(左図)。
|
TaはCoより酸化しやすいことから、図2に示すように、界面にTa酸化物層が自動的に形成される。
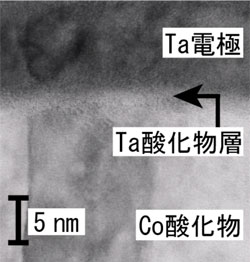 |
|
図2:今回開発したRRAM素子の透過型電子顕微鏡写真
メモリー素子断面における陽極側の界面構造を拡大して示した。Ta電極とCo酸化物との界面には、固体化学的に酸化が起こりやすいTa電極の酸化物層が、自動的に形成される。
|
このメモリー動作時の酸化と還元に係わる酸素イオンの量は、書き換え時に用いる電圧・電流パルスによって定量的に制御できる。動作電流を100~200マイクロアンペアに制御したときのRRAM素子におけるオン・オフ動的動作の評価結果を図3に示した。
 |
|
図3:今回開発したRRAM素子のオン・オフ動作特性
図1のオフ状態にあるメモリー素子に対して、2.2ボルト高さの50ナノ秒パルスを印加するとオンになる(左図)。図1のオン状態にあるメモリー素子に対して1.4ボルト高さの50ナノ秒パルスを逆向きに印加するとオフになる(右図)。
|
低電流で高速動作させることが可能になったことから、メモリー動作に必要なトランジスタも微細化できることとなり、RRAMが超微細メモリー素子となりえることが示された。
従来、酸化物を用いたメモリーには貴金属の電極が使われることが多かった。しかしながら、今回開発したRRAMでは、貴金属を用いずに安定なメモリー動作を実現した。相補型金属酸化膜半導体(CMOS)などシリコン素子の製造プロセスで活用されている各種金属材料を用いることができるので、この不揮発性メモリーは、省エネルギー・省資源に寄与するものである。さらに、超大容量メモリーとして製品化される際には、現行の製造プロセスとの整合性が高いため、新たに必要な設備投資を抑えることができることから、RRAMはビットコスト競争力にも優れていると考えられる。
今後は、集積回路を用いた信頼性テストを実施するとともに、集積化と大量生産のための技術開発を進め、早期の実用化・事業化を目指す。