独立行政法人 産業技術総合研究所【理事長 吉川 弘之】(以下「産総研」という)パワーエレクトロニクス研究センター【センター長 荒井 和雄】は、独自に開発したIEMOS(Implantation and Epitaxial MOSFET)と呼ばれるトランジスタ構造において、ノーマリーオフ型でSiCパワーMOSFETの高チャネル移動度を実現することにより、耐圧1100Vで、オン抵抗を4.3mΩcm2まで下げることに成功した。この値は、これまでの世界最小値であり、現在パワー素子として広く使われているSi-IGBT(Insulated Gate Bipolar Transistor)と比較し1/5なので、動作時の電力損失も1/5と非常に小さい。今後この素子は、スイッチング電源、エアコン、無停電電源UPS、電気自動車/ハイブリッド車のインバーター等へ適用することで、これまでSi系素子で失われていたスイッチング損失を大幅に削減でき、技術的に限界とされていた家電製品の更なる省エネルギー化も可能となり、次世代の省エネルギーでエコロジー向けのスイッチング素子として期待される。
DIMOS(
Double-Implanted MOSFET)と呼ばれるSiCパワーMOSFETにおいては、ゲート酸化膜と接しているPウエルと呼ばれるSiC領域(図3・5)は、アルミニウムをイオン注入した後に、1600℃以上の高温で熱処理をして形成される。この時に、熱処理前は平坦であるSiC表面から、Siが蒸発することにより、表面が荒れて、凹凸が大きくなる(図4)。ここを流れる電子が凹凸部分に衝突して散乱されることにより、電子が流れにくくなるので、オン抵抗値が高くなる。これに対して、産総研が独自に開発したIEMOSでは、Pウエルの表面は、エピタキシャル層で形成しているため、1600℃以上の高温での熱処理が必要なく、平坦であり(図6)、電子の流れが良くなり、4.3mΩcm
2という世界最小のオン抵抗値を達成した。また、Pウエルの底部は、高濃度のイオン注入で形成されると同時に、Pウエル間のN型領域の構造を耐圧がでるように設計することにより、1100Vの高耐圧を得ることにも成功した。さらに、この素子はゲート電圧が印加されていない時は電流が流れないノーマリーオフ型であるので、通常のインバーターに適用する場合にゲート制御が容易にできる特長も有する。
現在、通常用いられているSi-IGBTのオン抵抗値は耐圧1000Vで、約20mΩcm2であるが、今回のIEMOSのオン抵抗値は、4.3mΩcm2であり、Si-IGBTの約1/5と非常に小さい。また、Si-IGBTはバイポーラ型デバイスなのでスイッチング速度が遅く、スイッチング時の電力損失も大きいという問題がある。今回開発したSiC-IEMOSは、オン抵抗値が小さいだけでなく、ユニポーラ型であるためにスイッチング速度が速いことも大きな特長である。
本成果の詳細は、3/29~4/1に埼玉大学で開催される2005年春期 第52回応用物理学関係連合講演会において発表する予定である。
本技術研究開発は、経済産業省からの交付金を原資とし実施する「エネルギー使用合理化技術戦略的開発」事業の一つとして、独立行政法人 新エネルギー・産業技術総合開発機構の委託契約に基づき産総研が実施してきた成果である。
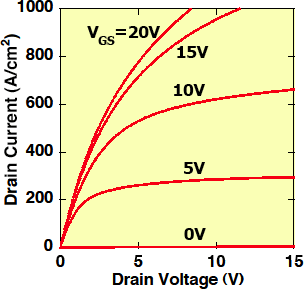
図1 開発したIEMOSの電流-電圧特性
オン抵抗:電圧÷電流=4.3mΩcm2(Vd=1V,Vg=15V(3MV/cm))
|
|
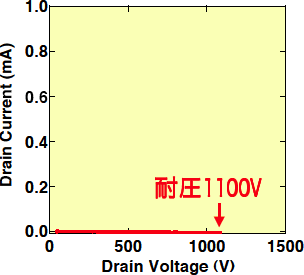
図2 開発したIEMOSの逆方向特性
1100Vまでは、電流が流れないが、それ以上では大電流が流れ、素子が破壊する
|
SiC素子は、理論的には通電状態での抵抗値を既存のSi素子よりも2桁下げることができる。エアコンやIHヒーター等の家庭用電化製品や、車載用半導体素子、配電系の大電力変換素子にSiCが使用されると電力損失を大幅に削減できると期待されている。SiC基板は、日本、ヨーロッパ、アメリカの企業が販売している。3インチ基板の販売も開始され、SiC素子産業の下地はできつつある。通常、エアコンやIHヒーターでは、SBDなどの整流素子とパワーMOSFETやIGBTのようなスイッチング素子を組み合わせて使用される。このうち、SiCのSBDのオン抵抗は、ほぼ理論値まで下がっている。SiC-SBDは、ドイツやアメリカの企業が販売を開始するなど、ビジネス展開へ向けて進んでいる。一方、SiCパワーMOSFETは、オン抵抗が小さくスイッチング速度が速いために、スイッチング素子として期待されている。しかしながら、オン抵抗は、Siのそれを下回ったものの、理論的限界値よりはかなり大きく、エアコンやIHヒーターで使用された場合に十分にSiC素子の性能を発揮するに至っていない。SiCパワーMOSFETのオン抵抗が高い理由は、オン抵抗の大部分を占めるチャネル抵抗が大きいためである。これは、Siと比較して、ゲート酸化膜とPウエルの界面(境界)に存在する欠陥が多いことや、図4に示したように、ゲート酸化膜下のチャネル部の凹凸が大きく、電流が流れにくいことに起因している。低損失のSiCパワー素子を様々な家電や産業機器に普及して、消費電力を削減するためには、SiCパワーMOSFETの開発が急務であった。
DIMOSと呼ばれる代表的なパワーSiC-MOSFET(図3)においては、ゲート酸化膜と接しているP型のSiC領域(Pウエル)は、アルミニウムをイオン注入した後に、1600℃以上の高温で熱処理をすることにより形成される。この時に、熱処理前は平坦なSiC表面から、Siが蒸発することにより、表面が荒れて、凹凸が大きくなる(図4)。ここを流れる電子が凹凸部分に衝突して散乱されることにより、電流が流れにくくなるので、オン抵抗値が高くなる。これに対して、産総研 パワーエレクトロニクス研究センターでは、独自にPウエルの底部を高濃度のイオン注入(Implantation)で形成し、上部をエピタキシャル層(Epitaxial layer)で形成する新たな構造のIEMOS(Implantation and Epitaxial MOSFET(図5))を開発した。上部は、シランとプロパンの化学反応によりエピタキシャル層を形成しており、アルミニウムの活性化熱処理が必要なく、SiC表面が荒れることはなく平坦であるので(図6)、電子の流れが良くなり、4.3mΩcm2という世界最小のオン抵抗値を達成した(図7)。また、Pウエルの底部にイオン注入で設けた高濃度層とPウエル間の構造設計により、1100Vの高耐圧を達成した(図6)。図7にSiCパワーMOSFETオン抵抗の成果を示す。これまでの世界最高性能のSiCパワーMOSFETを実現したことになる。(最近、ローム社から1030V、7.15mΩcm2のDIMOSの発表があった。)さらに、この素子は、パワーエレクトロニクス分野で通常使用される、ゲート電圧が印加されていない時には電流が流れないノーマリーオフ型であるので、広範な汎用性を有しており、パワーエレクトロニクス分野に与える影響は大きい。4.3mΩcm2を現在、Si素子の中で最も低いオン抵抗が得られているSi-IGBTのもの(約20mΩcm2)と比較してみると、約1/5と非常に小さい。さらに、Si-IGBTはバイポーラ型デバイスなのでスイッチング損失が大きく、スイッチング速度が遅い問題があるが、今回開発したSiC-IEMOSは、ユニポーラ型であるためにスイッチング損失も小さくスイッチング速度が速いことも大きな特長である。
今後の予定
今回、世界で初めて、ユニポーラ型素子で1100Vもの高耐圧で、オン抵抗4.3mΩcm2以下を達成した。今後、さらに、オン抵抗を下げ、理論的限界値の1~3mΩcm2を目指し、エアコンやIHヒーター等の家庭用電化製品や、車載用半導体素子、配電系の大電力変換素子へのSiC素子の普及を図る。