近年、半導体、プラズマディスプレイ、太陽光発電パネル、薄膜センサー等の製造分野で、プラズマを用いた材料プロセス技術が急速に進展してきている。プラズマを用いた材料プロセス技術の急速な進展に伴い、プラズマ材料科学から半導体製造技術、真空機器製造技術等広い分野において、“プラズマ・気体の統合的な計算システム”の開発が強く切望されていた。しかしながら、プロセスに関わる電子や、イオン、中性ラジカル等が気相中や機器・基板の表面で様々な物理的、化学的な反応を引きおこし、それらの時間及び空間スケールが極端に異なることや、非平衡プラズマの非線形性が強いことから、単一の物理モデル・数学モデルでは数値解が得にくいため、これを克服した系全体における気体・固体・プラズマの相互作用を取り扱う計算プログラムの開発が強く望まれていた。
独立行政法人 産業技術総合研究所【理事長 吉川 弘之】基礎素材研究部門(部門長 五十嵐 一男)高耐久性コーティング研究グループ・宮川佳子主任研究員らは、ペガサスソフトウェア(株)(代表取締役 高崎 敏英)と共同で、プラズマプロセス・希薄気体解析に用いる統合的な計算プログラムを完成した。これにより、プロセスのガスの流れ、プラズマの挙動、スパッタリング・エッチング等プラズマと真空容器内壁あるいは試料表面との相互作用の計算機解析が可能となった。
開発した計算プログラムは、モジュール群を数多く用意しそれらのモジュールを目的に応じて選択・統合して使用するもので、広範囲な応用技術への拡張が容易である。系全体のプロセス解析に本計算プログラムを用いる事により、装置開発・改良の効率化、実験及び試作コストの大幅な低減が期待できる。
本計算プログラムにより、PECVD装置、エッチング装置、プラズマディスプレイパネル、マグネトロンスパッタリング装置、イオン注入装置を初め、各種真空装置等のプロセス解析が可能である。
完成したプラズマ・気体プロセス解析用計算プログラムは"PEGASUS"の名で、ペガサスソフトウェア(株)から会員向けに、8月から販売されているが、12月からは一般への販売が開始される。それぞれの装置に最適なモジュールの組合せ等のコンサルティングも同社が行う。
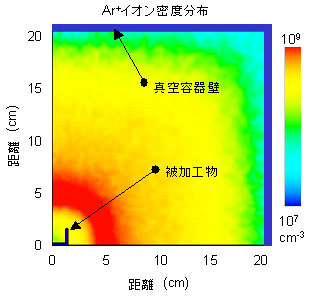 |
|
シミュレーション結果の一例:
断面がH型の被加工物に正のパルス電圧(最大電圧2kV、パルス長5µs)を印加したときに発生するプラズマ密度の空間分布。被加工物の周囲に高密度のプラズマが発生していることが分かる。
|
プラズマ材料科学は、我が国の国家戦略的基盤科学として、また、日本が世界に誇る先導的基礎科学としてその役割は益々重要なものになっている。しかしながら、近年、多くの学問分野で革新的な成果をあげている「計算科学」の本分野への応用は、残念ながらかなり遅れている。その理由として、(1)固体・気体・プラズマ間の相互作用が複雑であるにも関わらず、研究者、製造・設計技術者の連携した開発研究がほとんど無いこと、(2)一般にプラズマシミュレーションにはかなりの計算時間が必要であること、 (3)種々の反応データベースの整備が遅れていること等が挙げられる。これらの課題を克服した“プラズマ・気体の統合的な計算システム”の開発・創製が切望されていた。
本研究グループは、イオンビームと材料表層との相互作用に関する研究を行い、注入線量に依存して変化する物理量をシミュレートできる計算プログラムdynamic-SASAMALを先に開発した。
現在、プラズマ源イオン表面改質技術(PIII/D)に関する研究に取り組んでおり、このPIII/Dプロセスを解析する必要から、ペガサスソフトウェア(株)と協力して、同社が既に開発していた気相解析用計算プログラムのイオンと材料表面との相互作用部にdynamic-SASAMALを組み込んだプラズマプロセス解析用計算プログラムの開発に取り組んできた。
プラズマ源イオン注入表面改質技術を用いることで、大面積でしかも複雑な立体形状の表面処理が可能であるが、その実用化には、被加工物表面への均一なイオン注入を実現することが不可欠である。そのためには、(1)被加工物へのパルス電圧印加により生ずるシース形状の時間発展、(2)それに伴うイオンエネルギー、(3)イオン電流の分布の解析及び(4)その結果の装置設計への反映が非常に重要である。また、複雑形状をした部品表面へのイオン注入あるいはコーティングにおいて、この新しい技術を確立するためには、プロセスの詳細な解析が非常に重要で、そのために、プラズマプロセス解析用計算プログラムの開発が急務であった。
我々の研究グループでは、バイポーラパルス・プラズマ源イオン注入表面改質技術の開発研究に取組んでいるが、本プラズマプロセス解析用プログラムを用いた解析により、正のパルス電圧印加により被加工物の周りに容易に非常に強いプラズマが発生することが明らかになり、外部プラズマ源なしのプラズマイオン装置の有効性を実証することが出来た。これは、本プラズマプロセス解析用プログラムに、原子衝突による励起、電離のプロセス解析が組込まれているからこそ可能となった。また、真空容器や、試料表面におけるスパッタリング現象もdynamic-SASAMALにより解析されるため、微小細孔内部のプラズマの解析も正しく行われる。[2002年9月3日、イオンビームを用いた表面改質に関する第13回国際会議(神戸国際会議場)で一部研究発表、2002年12月20日、日本MRS学術シンポジウム(東京工業大学)で研究発表予定]
開発したプラズマプロセス解析計算プログラムは、モジュールを替えることにより、低圧ガスプラズマの解析から、高圧ガスの流れまで、広範囲に対応している。[パルスプラズマ・高パワーパルス日米シンポジウム(2002年8月4-8日ハワイ・コナ)で一部を研究発表]