独立行政法人 産業技術総合研究所【理事長 吉川 弘之】(以下「産総研」という) 光技術研究部門【部門長 小林 直人】は、株式会社 半導体プロセス研究所【代表取締役社長 前田 和夫】(以下「半導体プロセス研究所」という) と共同で、産総研が開発した陽電子(電子の反粒子)を利用した測定法を用いて、次世代高性能半導体集積回路(LSI)実現の鍵をにぎる低誘電率絶縁膜のサブナノ~ナノメートル領域の微小な空隙の測定に成功し、この微小空隙が誘電率などの諸特性と直接関連があることを解明した。この測定技術によって、次世代高性能半導体LSI用材料の開発スピードを大幅に速めることができると期待される。
○サブナノ~ナノメートルの微小空隙の測定はこれまで困難だった
次世代高性能半導体LSIの開発においては、LSI内配線の信号遅延を極小化できる低誘電率層間絶縁膜の開発がキーポイントとなっている。低い誘電率の絶縁膜を実現するために、現在、材料中に微小空隙を導入する研究がなされている。この微小空隙は、電気的性質、機械的性質等の諸特性に影響を及ぼすことから、空隙サイズやサイズ分布を測定し、それを最適化する必要がある。10ナノメートル以上の空隙は電子顕微鏡などの一般的な測定法によってその構造を調べることができたが、デバイスが微細化してくると、さらに小さな空隙が必要になる。しかし、サブナノメートルからナノメートルの領域の微小空隙は、一般的な方法では調べることが難しかった。
○産総研では超微小空隙を測定できる陽電子・ポジトロニウム寿命測定装置を開発
半導体プロセス研究所では、工業化の可能な安価な低誘電率絶縁膜の成膜法を開発
産総研では、高強度陽電子ビームを用いた陽電子・ポジトロニウム寿命測定装置という、特定の深さの微小空隙サイズを測定できる測定法を世界に先駆けて開発し、原子力基盤技術クロスオーバー研究によりこの測定法を材料開発に利用する研究を行ってきた。一方、半導体プロセス研究所では、安価で工業的にメリットのある原料ガス(HMDSO)を使用したプラズマCVD法による低誘電率絶縁膜の成膜法を開発した。この方法では、実用的な温度においてガス圧やプラズマ電力などの条件を変えるだけで低い誘電率や銅拡散に対する耐性の良好な膜ができる。しかし、この方法で成膜した膜の空隙は従来の低誘電率絶縁膜の空隙に比べて小さく、従来の測定法ではその構造を詳しく調べることができなかった。
○サブナノ~ナノメートルの超微小空隙のサイズ分布測定に成功
次世代半導体デバイスに最適な材料開発に道を拓く
そこで、このプラズマCVD方法で成膜した膜に対して、陽電子・ポジトロニウム寿命測定を行ったところ、サブナノ~ナノメートルの微小空隙のサイズ分布測定に成功した。さらに、この微小空隙が誘電率などの諸特性と直接関連があることを解明し、CVD法では空隙のサイズを自在に変えることができ、この空隙によって誘電率などの諸特性を制御できることを明らかにした。
今後、この測定法を各種の低誘電率層間絶縁膜に適用し次世代半導体デバイスに最適な材料を探求する予定。さらに、ナノテクノロジー材料・光エレクトロニクス材料などの他分野の高機能材料開発にもこの測定法を応用する予定。
パソコンや携帯電話のようなエレクトロニクス機器の普及は、IT革命として社会構造に大きな変革をもたらしつつある。このエレクトロニクス技術の核となるのが大規模半導体集積回路(LSI)技術であり、この加工技術の微細化はムーアの法則として知られているように3年で4倍の集積度を実現するピッチで進んでいる。次世代半導体LSIでは100nm以下のレベルの加工寸法の領域に突入し、この領域では原子数個のレベル(サブナノ~ナノメートル)の構造の制御が必要になってきている。
次世代半導体の開発において、重要課題の一つに低誘電率の絶縁膜の開発がある(図1)。微細化したLSIの動作周波数を上げようとする時にLSI内の配線間を絶縁している材料の誘電率が高いと信号が遅延してしまうため、できる限り誘電率が低く半導体プロセスにも適合する絶縁材料についてグローバルな開発競争が行われている。
この低誘電率材料の開発において、真空の誘電率が最も低いことから、絶縁材料の中に微小な空隙を導入して誘電率を下げる研究がなされている。しかし、空隙の存在によって機械的強度の低下、電気的特性の低下、新しい配線材料である銅の絶縁体中への拡散などの問題が出てくることから、空隙サイズを調べ、その構造をコントロールする技術が必要となってきている。特に、LSIの配線が微細化してくると、空隙のサイズもサブナノ~ナノメートルの領域でコントロールする必要がある。10ナノメートル以上の空隙は、電子顕微鏡などの一般的な測定法によってそのサイズを調べることができたが、数ナノメートル以下の領域になると、電子顕微鏡ではコントラストが弱くなり空隙サイズを調べることが難しくなる。1ナノメートル~10ナノメートル領域の空孔サイズを調べる方法としては、ガス吸着法という方法があるが、それよりさらに小さな空孔では、この方法も使うことができなかった。サブナノ~ナノメートルの構造を調べる方法として、X線や中性子の散乱を用いる方法があるが、この方法は空隙と塊(粒)との区別が難しい、深さ方向の情報が得られないという問題があった。
これに対して、エネルギーの揃った陽電子ビームを用いる陽電子・ポジトロニウム寿命測定法は、陽電子を半導体デバイスの動作で重要な数ナノメートル~数マイクロメートルの任意の深さに打ち込むことができ(図2)、その特定の深さのサブナノ~ナノメートルの空隙について非破壊で調べることができるという特徴を持っているため、次世代低誘電率絶縁膜の評価方法として期待されている。
産総研(旧電子技術総合研究所)では、1986年より電子加速器を用いた高強度低速陽電子ビームの開発とその利用研究を行ってきており、1991年、エネルギーの揃った短パルス陽電子ビームを試料に入射して陽電子及びポジトロニウムの寿命を測定することができる陽電子・ポジトロニウム寿命測定装置を世界に先駆けて開発した(図3, 特許取得済)。この装置によって、イオン注入によって形成される原子空孔やアモルファスシリコン薄膜やポーラスシリコン薄膜の中に存在するナノメートルサイズの空隙を観測できることを実証した。
その後、文部科学省の原子力試験研究(原子力基盤技術クロスオーバー研究)によってこの装置の高性能化を行い、実用的な測定時間(数分程度)、低いバックグラウンドで陽電子・ポジトロニウムの寿命スペクトル測定ができるようになった。
半導体業界では、数年ほど前からこれまでのLSI配線の絶縁体の主流であったシリコン酸化膜の限界が見え始め、スピン塗布法による成膜法が容易に低誘電率絶縁膜を得ることができる方法として開発されてきた。米国では2年ほど前にこの低誘電率膜に対してポジトロニウム寿命測定がなされ、数ナノメートルの空隙の測定に有効であることが確認された。(スピン塗布法により形成した膜についてはその後当グループでも陽電子・ポジトロニウム寿命測定を行い、その有効性を確認し、学会等で公表している。) しかし、米国の装置は当グループの装置に比べて分解能等が劣りサブナノメートルの領域の測定はなされていなかった。
最近、半導体プロセス研究所の研究グループは、プラズマCVD法を用いて低誘電率の膜を形成する新技術を開発した。この方法は、材料が安く工業的にメリットの有るHMDSO(ヘキサメチルジシロキサン)を使用して、375℃という実用的な温度で誘電率を2.6台にでき、しかも同一組成か、NH3ガスを添加して基板バイアスを印可することにより良好な銅拡散に対するバリアー膜を形成することができることから、次世代半導体用の絶縁膜形成プロセス技術として期待されている。
この方法により成膜した絶縁膜は、スピン塗布法によって形成する膜より空隙サイズが小さいと予想されたが、従来の方法で空隙サイズを測定することは難しかった。そこで、この膜に対して陽電子・ポジトロニウム寿命測定を行ったところ、サブナノ~ナノメートル領域の空隙サイズ分布の測定に成功した(図4, 5)。さらに、空隙サイズ分布の形や平均サイズがCVD法のプラズマ電力やガス圧等の条件によって変化し、そのサイズ変化が誘電率等の物性の変化に対応していることを明らかにした(図6)。この結果は、プラズマCVD法の成長条件によって空隙のサイズを人為的にコントロールすることができ、それによって誘電率や銅拡散に対する耐性等の物性を制御できることを示唆している。
次世代半導体デバイス用の低誘電率絶縁膜は、単に誘電率が低いというだけでなく、機械的強度、熱的安定性、銅拡散に対する耐性、電気的特性、プロセスとの整合性など、多くの条件を満たす必要がある。その多くは低誘電率絶縁膜内の微小空隙の構造に関係している。今後の次世代半導体開発においては、さらに低い誘電率の絶縁膜が必要とされ、各条件を満たすにはその構造の評価と制御もますます重要になってくる。そこで、陽電子ビームを用いた陽電子・ポジトロニウム寿命測定法によって各種の低誘電率絶縁膜を調べ、次世代半導体デバイス開発に寄与したいと考えている。
また、この測定法は、次世代半導体デバイス用材料だけでなく、ナノテクノロジー材料・光エレクトロニクス材料など他分野の材料中の微視的構造測定にも有効であると考えられることから、これらの材料開発にも応用していきたい。
図1 高性能LSIロードマップと低誘電率層間絶縁膜の必要性
図2 陽電子の入射深さ分布
入射エネルギーが1 keV, 3 keV, 10 keVの場合.
入射エネルギーによって測定深さを自在に変えることができる。用語の説明
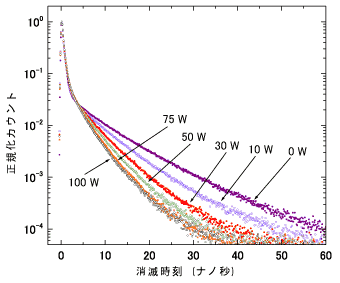
図4. PECVD成長低誘電率膜の陽電子寿命スペクトル
測定条件: 深さ 約150 nm, HMDSO 50 cc/min, N2O 200 cc/min
He 400 cc/min, 375oC 1.5 Torr, RF(13.56 MHz) 250 W, LF(380 kHz) 0-100 W
プラズマCVD成長時のLF電力を変化させると寿命スペクトルが変化する。->空隙サイズが変化。
|
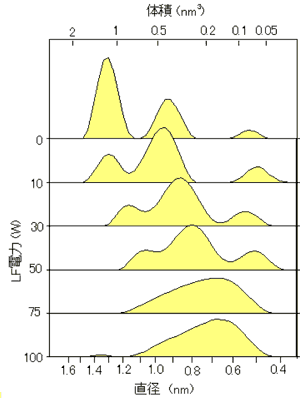
図5. 図4の寿命スペクトルから計算した空隙サイズ分布
LF電力の増加によってサイズの大きい空隙の割合が少なくなっている
|
図6 空隙を球と仮定した時の直径の平均値(左目盛, ○)と誘電率(右目盛, ▲)のプラズマ成長時のLF電力依存性
空隙サイズと誘電率とで相関関係があり、この結果はサブナノ~ナノメートルの空隙が誘電率に直接関連していることを示している。