慶應義塾大学理工学部電子工学科の内田建教授らは、独立行政法人産業技術総合研究所【理事長 中鉢 良治】(以下「産総研」という)ナノエレクトロニクス研究部門【研究部門長 金丸 正剛】と共同で、産総研つくばイノベーションアリーナ推進本部【本部長 金山 敏彦】スーパークリーンルーム運営室の支援を受け、先端トランジスタの作製・評価技術を駆使し、さまざまな構造の微細トランジスタにおける動作中温度の正確な測定に成功しました。ナノメートル・スケールの素子では動作中の温度上昇が無視できないことを見いだし、温度を下げるための素子設計指針を開発しました。
この研究成果によって、次世代のPCやスマートフォンなどに用いられる半導体集積回路の高信頼性化が期待されます。
本研究成果の詳細は、米国ワシントンDCで12月9日~11日(現地時間)に開催されるIEEE International Electron Devices Meeting (IEDM2013)にて発表されます。
半導体集積回路(LSI)は、PCやスマートフォンをはじめとしたあらゆる電子機器の心臓部であり、現代の情報化社会の発展はLSI性能の飛躍的な向上に支えられてきたと言っても過言ではありません。スマートフォンやタブレットなどのモバイル機器の普及による低消費エネルギー化の要請から、高速計算と低消費電力を両立できるLSIが強く求められています。しかし、従来手法によるLSI性能の向上は近年ますます難しくなってきています。
高速性と低消費電力性の両立のために、シリコン酸化膜(
Buried-Oxide: BOX層)上に単結晶シリコン(
Silicon-On-Insulator: SOI層)が形成されたSOI基板の導入が検討されています。SOI基板を用いたトランジスタは、多くの研究グループによって盛んに研究されています。SOI基板に作製したトランジスタは多くの優れた点を持つ一方で、トランジスタ動作中にチャネル近傍の局所領域の温度が、周囲に比べて上昇してしまうことが指摘されています。この局所的な温度上昇によって集積回路の信頼性が低下し、また集積回路全体の消費電力が上昇することも懸念されます。従って、SOI基板を用いたトランジスタにおいては、動作中の局所的な温度上昇を抑制することが重要な課題と言えます。トランジスタの温度を下げるためには、まずはトランジスタが動作している時のチャネル部分の温度を正確に測定することが不可欠です。これまでにもトランジスタの温度を見積もる研究は行われていましたが、ナノメートル・スケールのトランジスタ温度、特に動作中の温度の正確な測定は行われていませんでした。
産総研ナノエレクトロニクス研究部門は、スーパークリーンルーム運営室の支援を受けて、ゲート長が40 nm程度の先端トランジスタを作製しました。産総研で作製した素子は、従来構造のバルクトランジスタ(バルク基板上に作製したトランジスタ)に加えて、6 nmの極薄膜BOX層を持つSOI基板上に作製されたSOIトランジスタも含んでいます(図1)。トランジスタの動作中の温度を、4端子ゲート法という手法によって測定しました。慶應義塾大学内田教授のグループは、温度変化に伴う抵抗変化の大きなニッケルシリサイド(NiSi)を多結晶(Poly)シリコンに貼り付けた4端子ゲート電極構造を採用し、高精度の抵抗評価技術と組み合わせることで、ナノメートル・スケールのトランジスタにおいて、これまで実現できていなかった非常に高い精度で温度を測定することに成功しました。
過去の研究から、SOIトランジスタの動作時温度はBOX層の薄膜化によって低減できることが示唆されていました。本研究ではさまざまなBOX膜厚のSOIトランジスタの温度を測定し、BOX層薄膜化によって動作時温度は標準的な動作条件において60 ℃程度下がるものの、40℃程度の温度上昇は依然存在することを明らかにしました。さらに、局所温度の上がりやすさに相当するパラメータであるトランジスタの熱抵抗は、基板全体の温度に依存することを初めて見いだしました。このことは、これまで考えられていたトランジスタの熱抵抗が基板全体の温度に依存しないとする局所温度上昇のモデルでは、トランジスタの温度を正しく評価できないことを示しています。
また、バルクトランジスタは、現在量産されているトランジスタの主流の構造ですが、このようなトランジスタではチャネル近傍の局所的な温度上昇は無視できると考えられていました。そのため、チャネル近傍の温度は上昇しないという前提で集積回路の設計は行われてきました。しかし本研究で正確に温度を測定することにより、特徴的サイズが40 nm程度のトランジスタでは標準的な動作条件においてチャネル近傍の温度が20 ℃以上も上昇していることが初めて見いだされました。さらに、バルクトランジスタの局所的な温度上昇が、チャネル領域への不純物イオン注入によるシリコンの熱抵抗の上昇に起因することを示しました。このことから、従来は電気的な条件からのみ最適化されていた不純物イオン濃度を、熱的な条件も考慮して最適化する必要があることが分かりました。
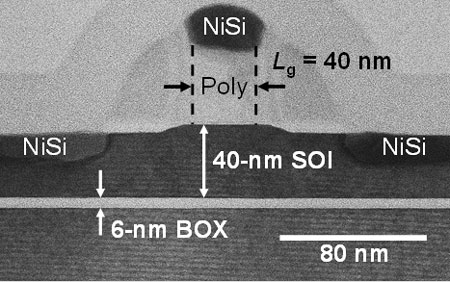 |
| 図1: BOX膜厚6 nmの極薄膜BOX SOI トランジスタの断面透過型電子顕微鏡写真。 |
今回の研究では、ナノメートル・スケールの先端トランジスタの温度を正確に測定することに成功し、従来は局所的な温度上昇が無いと考えられていた薄膜BOXのSOIトランジスタやバルクトランジスタにおいても、温度上昇は無視できないことを示しました。また、トランジスタの動作時温度を低減するために、不純物濃度の熱的観点からの最適化が重要であることを示しました。これは、次世代集積回路において高性能と高信頼性を両立する方向を示すものです。
本研究では長い時間トランジスタに電流を流した時の局所的な温度上昇を調べました。今後は、現実の集積回路の動作条件に近い、非常に短い時間スケールでトランジスタに電流を流した時の局所的な温度上昇の評価に取り組みます。
なお、本研究の一部は独立行政法人日本学術振興会の最先端・次世代開発支援プログラムより助成を受けています。